
Moldex3D
최고의 제품과 서비스를 제공하고 있습니다.
Moldex3D IC Packaging
Plastic Chip Encapsulation는 물리적 손상이나 부식을 방지하기 위해 칩을 에폭시 성형 화합물(EMC) 또는 액체 성형 화합물(LMC)로 캡슐화하는 성형 공정입니다.
이 공정에는 마이크로칩과 기타 전자기기 간의 상호 연결(Wire bonding), 열경화성 소재의 경화 현상, 공정 조건의 다양한 제어 관리 등이 포함됩니다.
여러 재료 구성 요소의 복잡성으로 인해 Chip Encapsulation 프로세스에 많은 어려움과 불확실성이 발생했습니다.
흔하게 발생하는 결함으로는 미성형, 에어트랩, 보이드, Wire Sweep, Paddle Shift, Package Warpage 등이 있습니다.

What Moldex3D Can Do
Moldex3D IC Packaging은 칩 설계자가 충전, 경화, 냉각부터 Wire Sweep, Die Shift, Filler Concentration, Underfill Encapsulation, Post-molding Curing, 응력 분포 또는 구조 평가와 같은 Advanced한 제조 요구 사항에 이르기까지 Chip Encapsulation 프로세스를 완벽하게 분석하는 데 도움이 됩니다.
중요한 성형 문제를 미리 예측하고 해결할 수 있으므로 엔지니어는 칩 품질을 향상하고 잠재적인 결함을 보다 효율적으로 방지할 수 있습니다.
정확한 시뮬레이션은 설계 최적화 및 최적의 비용 관리에도 도움이 됩니다.
Flow Pattern으로 칩 레이아웃 평가
• 게이트 및 러너 설계 평가
• 칩 레이아웃 및 흐름 균형 최적화
• 에어트랩 예측

구조 검증
• 유체 - 구조 상호 작용을 통한 Wire Sweep, Chip 변형, Paddle/Die Shift 예측
• Ansys 및 Abaqus와 같은 구조 해석을 연계시킨 시뮬레이션


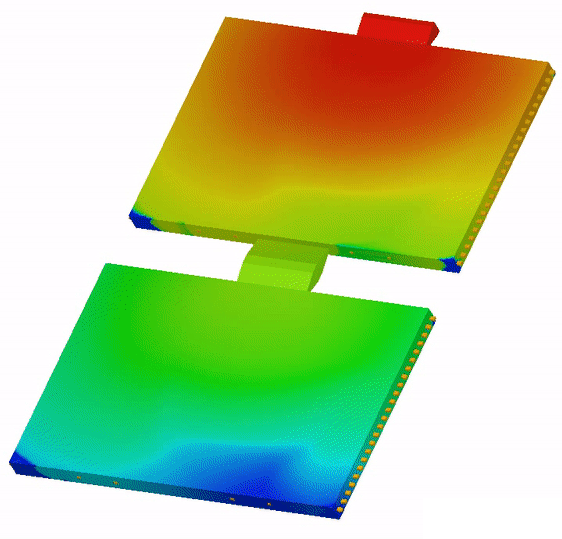
공정 변경의 효과 예측
• 실제 공정 조건을 기반으로 한 생산 시뮬레이션
• 재료 특성 및 공정을 기반으로 Warpage 예측
• 온도, 변환 및 응력 분포가 시각화합니다.

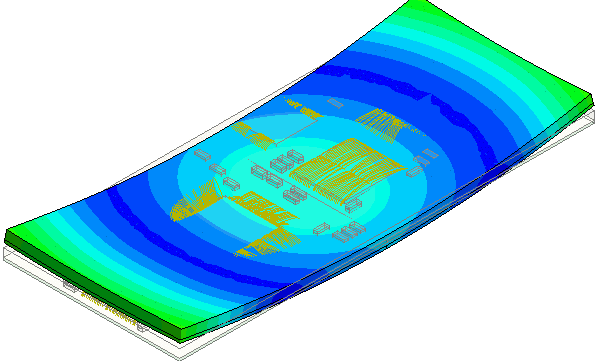
성형 후 경화 변형 시뮬레이션
• 응력 완화 및 화학적 수축 시각화
• 온도, 변환, 응력 분포 시뮬레이션을 통해 성형 후 경화 공정의 변형 예측

정확한 시뮬레이션을 위한 Advanced 재료 특성 측정
• 흐름 시뮬레이션을 위한 Curing Kinetics, 점도, 점탄성 특성 측정
• 변형 예측을 위한 점탄성 응력 완화, 화학적 수축 및 열팽창 효과 결정


Moldex3D는 IC Packaging을 위해 특정 공정 솔루션을 제공합니다.
Transfer Molding & Molded Underfill 시뮬레이션
• 게이트 및 러너 설계를 최적화하고 충진 및 경화 공정을 시각화합니다.
• 보이드의 위치, 미성형 등 잠재적 성형 결함 예측
• Air Zone 내부의 압력 강하를 계산하여 에어 벤트 설계 최적화
• 공정 조건 및 재료 특성을 평가하여 사이클 시간 단축
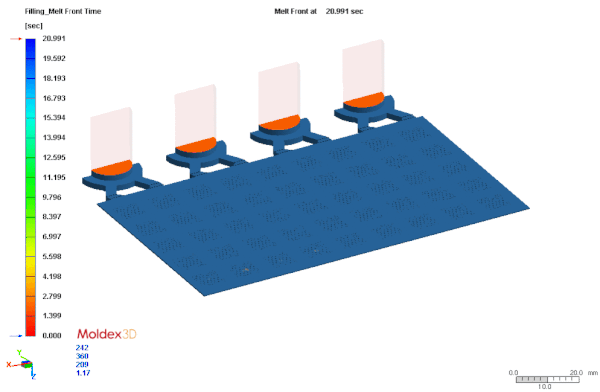
Compression Molding & Embedded Wafer Level Packaging 시뮬레이션
• Compression Molding 공정 동안에 다이나믹한 유동 선단을 시각화 합니다.
• Fan-out Package의 Warpage, Die shift와 Shear Stress의 분포를 평가
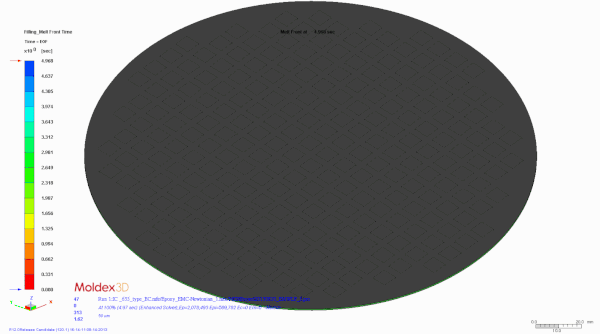
Capillary Underfill 시뮬레이션
• 다양한 표면 장력과 접촉각으로 Capillary-force-induced로 인한 충전 거동을 시각화합니다.
• Bump pitch와 Bump pattern으로 인한 흐름 효과를 평가합니다.
• Capillary Underfill 공정을 위한 Dispensing 세팅을 최적화합니다.


Potting
• 더욱 현실적이며 상세한 디스펜서의 pass와 feeding을 시각화 합니다.(potting & dotting)
• Creeping과 같이 표면 장력으로 유도되는 거동을 시뮬레이션 하기 위해 전체적인 Physical 모델이 적용됩니다.
• 다양한 프로세스 설계를 위한 사용자 친화적은 모델링 도구들과 설정 UI